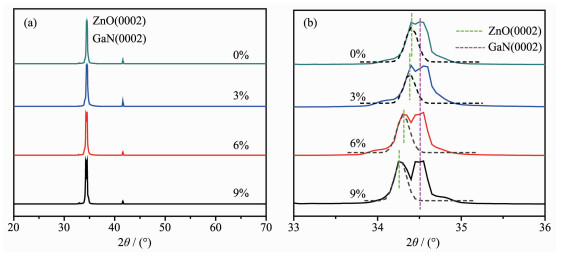 图1
不同Ag掺杂浓度的n-ZnO NRs/p-GaN异质结的XRD图(a)和局部放大图(b)
Figure1.
XRD patterns (a) of the n-ZnO NRs/p-GaN heterojunction with various Ag dopant concentrations and it′s closeup view (b)
图1
不同Ag掺杂浓度的n-ZnO NRs/p-GaN异质结的XRD图(a)和局部放大图(b)
Figure1.
XRD patterns (a) of the n-ZnO NRs/p-GaN heterojunction with various Ag dopant concentrations and it′s closeup view (b)

Citation: YU Chun-Yan, HU Fang, MEI Fu-Hong, LI Rui, JIA Wei, LI Tian-Bao. Effect of Ag-Doping on Structural and Photoluminescence Properties of n-ZnO Nanorods/p-GaN Heterojunction[J]. Chinese Journal of Inorganic Chemistry, 2018, 34(2): 289-294. doi: 10.11862/CJIC.2018.033

Ag掺杂对n-ZnO纳米棒/p-GaN异质结结构和发光性能的影响
English
Effect of Ag-Doping on Structural and Photoluminescence Properties of n-ZnO Nanorods/p-GaN Heterojunction
-
Key words:
- ZnO nanorod
- / Ag-doping
- / structure
- / photoluminescence
-
0 引言
ZnO具有较宽的禁带宽度(3.37 eV)和较高的激子结合能(60 meV),适合在光电器件如太阳能电池和发光二极管(LEDs)[1-4]中用作n-型半导体材料,其中基于ZnO一维纳米结构的LEDs作为固态发光的一种可替代材料近年来也引起了广泛的关注[5-7]。在以相对于基体垂直的纳米线(或棒)阵列为n型,薄膜为p型作为p-n结构成的最简单的非平面器件结构中,垂直取向的纳米线(或棒)阵列为注入电子提供了极好的传输路径[1, 8],而且也可充当被困光的逃逸路径,因此可提高器件的光提取效率[2-3],这使它在功能或工作原理上优于传统的平面p-n结LEDs。在由纳米线(或棒)阵列/薄膜构成的p-n结LEDs中,ZnO/GaN异质外延结构引起了研究者的广泛关注,因为GaN具有和ZnO相同的晶体结构(纤锌矿结构),且它们之间的晶格失配较小(约为1.8%),所以这种结构对于高性能的光电器件具有很好的物理性能相容性[9-12]。然而,为了得到高性能的器件,n-ZnO NRs/p-GaN异质结LEDs的发射效率和输出功率还不能满足要求,因为在异质结的界面能量势垒较高[13],导致载流子的注入效率较低。这个问题可以试图通过在ZnO NRs中加入其它的元素而解决,有研究者已通过加入Al、Ga、In、Cl、Sn、Cu和Br等元素来改变ZnO NRs的结晶度、尺寸和形貌,从而提高LEDs的电学和光学性能进行了研究[14-17]。理论研究也表明,用IB族元素对ZnO掺杂,在富氧条件下ZnO中IB族元素的形成能是较低的,其中Ag代替Zn位是最稳定的掺杂模式[18-19]。ZnO薄膜进行Ag掺杂后光学带隙减小,Ag可以起到调节其光学性质的作用[20-23]。本研究对n-ZnO纳米棒/p-GaN异质结中的ZnO进行Ag掺杂,对其形貌、结构和光学性能进行了表征。目的是试图通过Ag的掺杂来改变n-ZnO NRs/p-GaN异质结中的带隙偏移,平衡异质结上载流子的注入来增加ZnO中的缺陷辅助发射,从而提高n-ZnO NRs/p-GaN异质结LEDs的发光效率。
1 实验部分
1.1 试剂与仪器
实验试剂均为分析纯,其中醋酸锌(Zn(CH3COO)2·2H2O)、丙酮、无水乙醇和硝酸银(AgNO3)为天津市第三化学试剂厂生产,单乙醇胺和六次甲基四胺为天津市博迪化工股份有限公司生产,乙二醇甲醚为天津市光复精细化工研究所生产。
采用Y-2000 Automated X-Ray Diffractometer (XRD)对所得样品的物相进行分析,以连续扫描方式收集数据,扫描范围是15°~80°,扫描速度为0.05°·s-1。设备的测试条件是,管电压30 kV,管电流40 mA,Cu Kα射线(λ=0.154 18 nm),镍滤波片,正比探测器;采用日本电子株式会社(JEOL)JSM-6700F型场发射扫描电镜(SEM)观察样品的表面形貌,其测试电压为10 kV,工作距离为8 mm左右;采用美国Nanometrics公司生产的光致发光谱扫描仪(NAN-RPM2000 PL)对所得样品进行光致发光(PL)谱分析,该仪器采用YAG作激发光源,测量中使用的激发波长为266 nm,测试范围为200~1 100 nm;利用美国Perkin Elmer公司Lambda 950型紫外-可见-近红外分光光度计测试样品的紫外-可见光吸收光谱;采用FS-TL系列LED测试设备对样品进行伏安测试来表征异质结的电学性质。
1.2 Ag掺杂ZnO纳米棒的制备
首先通过金属有机化合物化学气相沉积方法(Metalorganic Chemical Vapor Deposition-简称MOCVD)在蓝宝石(0001)衬底沉积0.5 μm的p-GaN。然后用两步法在p-GaN上制备Ag掺杂ZnO纳米棒。沉积之前先将p-GaN分别用丙酮、酒精、去离子水各超声清洗10 min以去除表面油污,清洗完后用高纯N2吹干备用。沉积时先将醋酸锌溶于乙二醇甲醚(0.5 mol·L-1),并加入单乙醇胺稳定剂在60 ℃搅拌2 h配制成种子层旋涂液,然后采用低速和高速旋转将种子层溶液旋涂在p-GaN上,随后放入管式加热炉里在350 ℃下退火90 min,最后将涂有种子层的p-GaN垂直放入装有生长溶液的高压釜中,并在95 ℃下保温3 h。生长溶液是先由浓度为0.075 mol·L-1的Zn(NO3)2·6H2O与等浓度的六次甲基四胺溶液混合,然后再通过加入的AgNO3溶液的量使生长溶液中Ag的掺杂浓度分别为0%、3%、6%和9%。
2 结果与讨论
2.1 XRD分析
图 1(a)为未掺杂Ag以及不同Ag掺杂浓度的n-ZnO NRs/p-GaN异质结的XRD图,图 1(b)为GaN(0002)和ZnO(0002)衍射图。从图 1(a)中可以看出,不同Ag掺杂浓度的样品都在GaN(0002)和ZnO(0002)晶面(PDF No.36-1451)出现了一个较强的衍射峰和一个蓝宝石衬底的(0001)衍射峰,说明不同Ag掺杂浓度的ZnO纳米棒都呈六方纤锌矿结构,并具有良好的c轴择优取向性。图 1(b)为图 1(a)的GaN(0002)和ZnO(0002)晶面的局部放大图,并拟合出ZnO的(0002)面的衍射峰,由图 1(b)可以看出随着Ag掺杂浓度的增加,ZnO纳米棒的(0002)晶面的峰位向衍射角减小的方向移动,这可能是由于Ag原子的引入,使晶格常数发生了变化。据报道,Ag+半径为126 pm,Zn2+半径为76 pm,当Ag+进入晶格替换部分Zn+后,使ZnO的晶格常数增加,从而导致了掺杂Ag的ZnO样品的峰位移动[24-25]。在图 1(a)不同掺杂浓度的n-ZnO NRs/p-GaN的XRD图中并没有出现其它的杂峰,这表明在本实验中的掺杂浓度范围内并没有新的物相形成,说明掺杂的Ag已经固溶到ZnO的晶格当中。
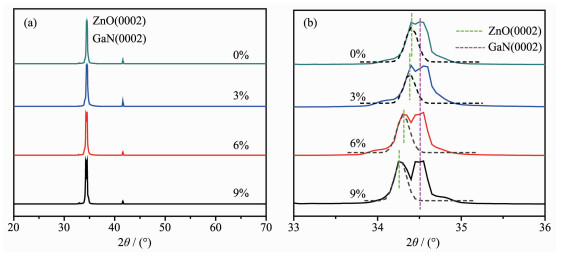 图1
不同Ag掺杂浓度的n-ZnO NRs/p-GaN异质结的XRD图(a)和局部放大图(b)
Figure1.
XRD patterns (a) of the n-ZnO NRs/p-GaN heterojunction with various Ag dopant concentrations and it′s closeup view (b)
图1
不同Ag掺杂浓度的n-ZnO NRs/p-GaN异质结的XRD图(a)和局部放大图(b)
Figure1.
XRD patterns (a) of the n-ZnO NRs/p-GaN heterojunction with various Ag dopant concentrations and it′s closeup view (b)
2.2 形貌分析
图 2(a)、(b)、(c)和(d)分别为Ag掺杂浓度为0%、3%、6%和9%的ZnO纳米棒的表面FESEM形貌。从图 2中可知不同Ag掺杂浓度的ZnO纳米棒均呈截面为六边形的棒状结构,且纳米棒的取向垂直于衬底,并完全覆盖了衬底的表面。从表 1中的不同Ag掺杂浓度下ZnO纳米棒的EDS能谱分析结果可知随着Ag掺杂浓度的增加,ZnO纳米棒中Ag与Zn的比值越大,这说明通过在水热法反应溶液中加入AgNO3溶液这种方法可以有效地将Ag原子掺入到ZnO纳米棒中。
 表 1
EDS能谱分析测量的ZnO纳米棒中Ag的原子百分比以及nAg/(nAg+nZn)的比率
Table 1.
Atomic Ag content and nAg/(nAg+nZn) ratio in the ZnO NRs by EDS
表 1
EDS能谱分析测量的ZnO纳米棒中Ag的原子百分比以及nAg/(nAg+nZn)的比率
Table 1.
Atomic Ag content and nAg/(nAg+nZn) ratio in the ZnO NRs by EDS
Atomic Ag content in the growth solution/% Atomic Ag content determined in the ZnO by EDS/% Atomic Zn content determined in the ZnO by EDS/% nAg/(nAg+nZn)/% 0 0 55.3 0 3 0.8 55.1 1.4 6 1.2 48.6 2.4 9 2.6 46.1 5.3 2.3 光学性能分析
图 3为不同Ag掺杂浓度的ZnO纳米棒的紫外-可见光吸收光谱。由于半导体材料不同其带隙能不同,相应的光吸收阀值λg也是不同的。按图 3中做切线的方法,可得到与横坐标的交点分别为:408、422、446和466 nm,根据半导体的光吸收阀值与带隙Eg的关系式[26]计算出不同Ag掺杂浓度的ZnO纳米棒的带隙分别为:3.10、2.90、2.79和2.67 eV。可见,ZnO纳米棒的带隙随着Ag掺杂浓度的增加而减小。半导体掺杂后带隙变窄是一个众所周知的普遍现象,在ZnO材料中也有报道[20-22, 27-28]。Nour等的研究表明,Ag掺杂ZnO纳米结构的光学带隙很大程度上决定于Ag在ZnO晶格中的位置[27]。本实验中随着Ag掺杂浓度的增加ZnO纳米棒的带隙减小,这可能是由于当Ag掺杂进入到ZnO晶格内时,Ag取代了晶格中Zn的位置,而Ag的原子半径比Zn的大,这导致ZnO的晶格常数增加,进而导致其带隙减小,Ag原子取代Zn的位置可由XRD结果证明。
图 4是不同Ag掺杂浓度ZnO纳米棒的室温PL谱图,测试中采用YAG作为激发光源,激发波长为266 nm。从图 4中可以看出Ag掺杂ZnO纳米棒的发光位置由1个375 nm紫外近带边发光峰和1个600 nm左右黄绿光发射峰组成。近紫外发光峰是由自由激子的复合引起的,黄绿光发射峰是由于导带与间隙原子、氧空位或杂质原子引起的深能级发光。随着Ag掺杂浓度的增大,近带边发光峰强度逐渐减弱,并出现一定红移。这是因为当对ZnO进行Ag掺杂时有两种模式,一种是Ag代替Zn作为替位原子,另一种是Ag作为间隙原子,在这两种掺杂模式中Ag离子在ZnO中都是充当受体[20, 29],由紫外-可见光吸收光谱图 3可知随着Ag掺杂量的增加,光学带隙降低,从而使近带边发光峰发生红移。另外,随着Ag掺杂浓度的增加近带边发光峰强度减弱,这是由于随着Ag掺杂浓度的增大,对ZnO有一定的能级补偿作用(如图 5中所示),使ZnO载流子浓度降低,从而降低了ZnO的辐射复合效率。黄带发光峰的强度随着Ag掺杂浓度的升高而增强,可能是由于随着Ag杂质原子的掺入,使得间隙原子和氧空位等缺陷增多,使ZnO纳米棒晶体质量有所下降从而导致深能级发光增强。因此可认为,通过Ag掺杂使得由带边激子复合引起的近带边发光峰中位置发生微小的红移,可知部分Ag原子进入晶格,有一定的能级补偿。此外由氧空位以及间隙原子引起的深能级发光增强表明Ag的掺入使ZnO的晶体质量略降低。
2.4 I-V特性分析
图 6为不同Ag掺杂浓度的n-ZnO NRs/p-GaN异质结LED的I-V曲线,插图为异质结LED结构示意图,p-GaN不仅充当了生长ZnO纳米棒的缓冲层,而且也是空穴注入层。图 6的I-V曲线表明n-ZnO NRs/p-GaN异质结LED具有一定的整流特性,同时随着电压的增加电流逐渐增大,且随着Ag含量的增加增量更大。随着Ag掺杂浓度的增加,试样的I-V曲线的斜率增加,表明随着ZnO纳米棒中Ag含量的增加异质结的导电性提高了,这可能是由于随着Ag掺杂浓度的提高增加了ZnO纳米棒中的载流子(电子)的数量,而载流子浓度的增加可减小接触电阻,因此随着Ag掺杂浓度的增加异质结的电阻减小,从而提高了其传输性能[30]。
3 结论
通过水热法在p-GaN衬底上制备了不同Ag掺杂浓度的ZnO纳米棒,形成n-ZnO NRs/P-GaN异质结。结果表明,不同Ag掺杂浓度的ZnO纳米棒都表现出了较强的c轴择优取向性,且随着Ag掺杂浓度的增加,ZnO(0002)面衍射峰向角度减小的方向发生微小移动,表明ZnO纳米棒c轴晶格常数增大。同时随着Ag掺杂浓度的增加,ZnO纳米棒的带隙减小,近带边发光峰位置发生一定的红移且发光峰逐渐减弱,黄带发光峰增强,这可能是由于Ag以替位原子或者间隙原子进入ZnO晶格后,使ZnO纳米棒中缺陷增加所致。同时随着Ag掺杂浓度的增加,n-ZnO NRs/p-GaN异质结具有更好的传输效率。
-
-
[1]
Lee Y J, Yang Z P, Lo F Y, et al. APL Mater., 2014, 2(5):056101 doi: 10.1063/1.4874455
-
[2]
Jeong H, Park D J, Lee H S, et al. Nanoscale, 2014, 6(8):4371-4378 doi: 10.1039/C3NR06584G
-
[3]
Ye B U, Kim B J, Song Y H, et al. Adv. Funct. Mater., 2012, 22(3):632-639 doi: 10.1002/adfm.201101987
-
[4]
Shen Y, Chen X, Yan X, et al. Curr. Appl. Phys., 2014, 14(3):345-348 doi: 10.1016/j.cap.2013.12.011
-
[5]
Liang Z, Cai X, Tan S, et al. Phys. Chem. Chem. Phys., 2012, 14(46):16111-16114 doi: 10.1039/c2cp43453a
-
[6]
Sun X W, Huang J Z, Wang J X, et al. Nano Lett., 2008, 8(4):1219-1223 doi: 10.1021/nl080340z
-
[7]
Jeong M C, Oh B Y, Ham M H, et al. Small, 2007, 3(4):568-572 doi: 10.1002/(ISSN)1613-6829
-
[8]
Kalele M H, Qiulong W, Owusu K A, et al. Adv. Energy Mater., 2015, 5:1500060 doi: 10.1002/aenm.201500060
-
[9]
Van C G, Neugebauer J. Nature, 2003, 423(6940):626-628 doi: 10.1038/nature01665
-
[10]
Hassan J J, Mahdi M A, Yusof Y, et al. Opt. Mater., 2013, 35(5):1035-1041 doi: 10.1016/j.optmat.2012.12.006
-
[11]
Mo X, Fang G, Long H, et al. J. Lumin., 2013, 137(9):116-120 http://www.sciencedirect.com/science/article/pii/S0022231312007715
-
[12]
Chen X, Ng A M C, Fang F, et al. J. Appl. Phys., 2011, 110(9):094513 doi: 10.1063/1.3653835
-
[13]
Hong S K, Hanada T, Makino H, et al. Appl. Phys. Lett., 2001, 78(21):3349-3351 doi: 10.1063/1.1372339
-
[14]
Park G C, Hwang S M, Lee S M, et al. Sci. Rep., 2015, 5:10410 doi: 10.1038/srep10410
-
[15]
Chen C H, Chang S J, Chang S P, et al. J. Phys. Chem. C, 2010, 114(29):12422-12426 doi: 10.1021/jp101392g
-
[16]
Bae S Y, Choi H C, Na C W, et al. Appl. Phys. Lett., 2005, 86(3):033102 doi: 10.1063/1.1851591
-
[17]
Cai F, Zhu L, He H, et al. J. Alloys Compd., 2011, 509(2):316-320 doi: 10.1016/j.jallcom.2010.09.016
-
[18]
Yan Y, Al Jassim M M, Wei S H. Appl. Phys. Lett., 2006, 89(18):181912 doi: 10.1063/1.2378404
-
[19]
Li Y, Zhao X, Fan W. J. Phys. Chem. C, 2011, 115(9):3552-3557 doi: 10.1021/jp1098816
-
[20]
Xu L, Zheng G, Zhao L, et al. J. Lumin., 2015, 158:396-400 doi: 10.1016/j.jlumin.2014.10.028
-
[21]
Kang H S, Ahn B D, Kim J H, et al. Appl. Phys. Lett., 2006, 88:202108 doi: 10.1063/1.2203952
-
[22]
Liu M, Qu S W, Yu W W, et al. Appl. Phys. Lett., 2010, 97:231906 doi: 10.1063/1.3525171
-
[23]
Thierry P, Oleg L, Jie Z, et al. ACS Appl. Mater. Interfaces, 2015, 7:11871-11880 doi: 10.1021/acsami.5b01496
-
[24]
Duan L, Lin B, Zhang W, et al. Appl. Phys. Lett., 2006, 88(23):232110 doi: 10.1063/1.2211053
-
[25]
Lupan O, Chow L, Ono L K, et al. J. Phys. Chem. C, 2010, 114(29):12401-12408 doi: 10.1021/jp910263n
-
[26]
刘恩科, 朱秉升, 罗晋生.半导体物理学.7版.PHEI, 2011:317-318LIU En-Ke, ZHU Bing-Sheng, LUO Jin-Sheng. Semiconductor Physics. 7th Ed. Beijing:Publishing House of Electronics Industry, 2011:317-318
-
[27]
Nour E S, Echresh A, Liu X J, et al. Aip Advances, 2015, 5:077163 doi: 10.1063/1.4927510
-
[28]
Gruzintsev A N, Volkov V T, Yakimov E E. Semiconductors, 2003, 37(3):259-262 doi: 10.1134/1.1561514
-
[29]
Fan J W, Freer R. J. Appl. Phys., 1995, 77:4795-4800 doi: 10.1063/1.359398
-
[30]
Resasco J, Zhang H, Kornienko N, et al. ACS Cent. Sci., 2016, 2(2):80-88 doi: 10.1021/acscentsci.5b00402
-
[1]
-
表 1 EDS能谱分析测量的ZnO纳米棒中Ag的原子百分比以及nAg/(nAg+nZn)的比率
Table 1. Atomic Ag content and nAg/(nAg+nZn) ratio in the ZnO NRs by EDS
Atomic Ag content in the growth solution/% Atomic Ag content determined in the ZnO by EDS/% Atomic Zn content determined in the ZnO by EDS/% nAg/(nAg+nZn)/% 0 0 55.3 0 3 0.8 55.1 1.4 6 1.2 48.6 2.4 9 2.6 46.1 5.3 -

 扫一扫看文章
扫一扫看文章
计量
- PDF下载量: 2
- 文章访问数: 3894
- HTML全文浏览量: 715


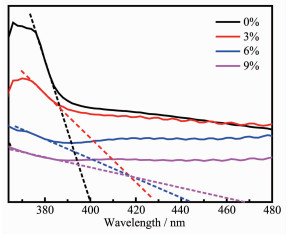
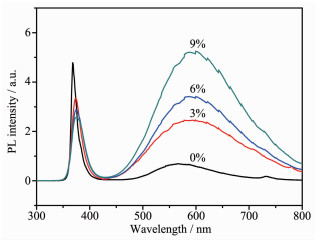

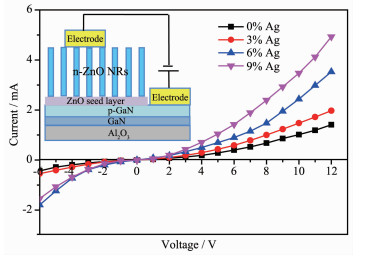

 下载:
下载:





 下载:
下载:

